
GaNインゴット:レーザーを連続照射
GaN ingot: continuous laser irradiation
GaN錠:連續激光照射
ーインゴットからウエハーを切り出しー
ーディスコのウエハー剥離新技術ー
日経クロステック(xTECH)記事からサマリーをお届けします。

精密加工装置メーカー:ディスコ
パワー半導体材料である窒化ガリウム(GaN)
インゴットからウエハーを切り出す工程の新プロセスを開発した(図1)
ディスコのGaN結晶塊からウエハーを剥離する新技術。
新プロセスを採用
日本のディスコが、「レーザーで速く無駄なく、ウエハーを剥離する技術」を2023年7月3日発表した。
2インチ(5cm)のインゴットの場合、ウエハーの取れ高が38%高まる。
1時間当たりの生産枚数が、従来比で6倍改善する。
現在は、試作機の段階。量産化に向けて開発を継続していく。
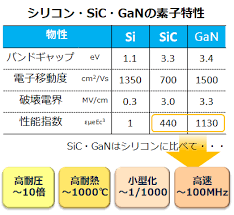
次世代パワー半導体材料GaN:
GaNは、シリコンカーバイド(SiC)を上回る物性値だ。
次世代パワー半導体材料として注目されている。
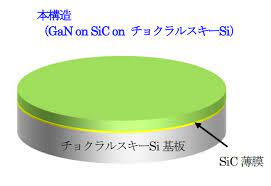
GaN基板は高価
最大限活するため、GaN基板の上にGaNの層を形成した縦型GaNが必要となる。
しかし、現時点でGaN基板は、SiやSiCと比べて高価である。
これが縦型GaN普及を妨げる原因の1つとなっている。

GaN向けKABRAプロセス
今回、ディスコが開発した新プロセス。
ディスコ は、SiC向けに「KABRA」と呼ぶプロセスを既に適用済みだ。
GaNインゴットに、スライスしたい深さで焦点を合わせたレーザーを連続的に照射する。
分離層を設け、所望の厚さのウエハーを剥離する。
これを研磨し、ウエハーとする。

ワイヤソープロセスの場合:
従来は、ダイヤモンドのワイヤソーを使った切り出しプロセスだ。
ワイヤソーの太さと同程度の厚み分だけ、材料損失が発生する。
さらに、切り出し時に、ウエハーの表面でうねりが発生する。
また切り出した後に、大きく表面を削らなくてはならない。

レーザー加工の場合
切り出しの材料欠損が最小限に抑えられ、表面がなめらかである。
レーザー加工は、スループットが高い。
切り出しおよび研磨時の材料欠損が少ない。
https://xtech.nikkei.com/atcl/nxt/column/18/01537/0086
2023 | News | DISCO Corporation
High mass-productivity:
Φ4 inch GaN Wafer after separation and grinding
High throughput:
Developed a special optical system and processing method optimized for GaN
Efficient creation of KABRA layer*1 due to short stage scanning distance
High yield:
Efficiently discharges the Nitrogen that is produced within the material and prevents wafer breakage by also creating a uniform KABRA layer near the edge of the ingot

KABRA Process Flow for GaN Wafer Mass Production
Laser is irradiated inside the ingot and KABRA layer is formed
Ingot separated into wafer
Wafer ground to specified thickness
Ingot upper surface ground for next laser irradiation
