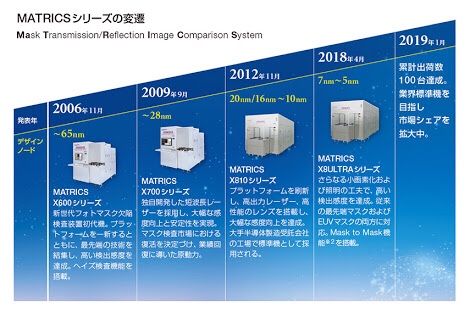

Lasertec: ACTIS’A150 ’announced: EUV Photomask defect inspection system
Lasertec: ACTIS’A150 ’
【Overview】
Lasertec has commercialized the ACTIS “A1550” defect inspection system that supports EUV mask pattern inspection.
The device will be presented at SPIE Photomask Technology + EUV Lithography 2019, an international conference on photomask technology to be held in the United States from September 15th.
[Contents]
Lasertec developed the world’s first automated photomask defect inspection system in 1976.
A company with a long history and experience in the field of mask inspection.
The MATRICS series of mask defect inspection systems currently on sale is well received by wafer fabs and mask shops around the world due to its excellent defect detection performance.
On the other hand, with the miniaturization of device patterns, mass production by EUV lithography, the next generation exposure technology, started.
To meet all requests for EUV masks,
In 2013, EUV mask backside inspection / cleaning equipment “BASIC series”
In 2017, EUV mask blank defect inspection / review system ABICS “E120”,
EUV mask inspection system MATRICS “ X8ULTRA series ” in 2018
Has been commercialized.
Conventional product: wafer yield rate
Actinic pattern inspection equipment using EUV light has not been commercialized so far.
Increasing the yield of wafers has been a challenge for building EUV mask manufacturing infrastructure.
This product: ACTIS “A150”
This issue is overcome by our successful commercialization.
EUV Mask Defect Inspection System ACTIS “A150” is the world’s first EUV pattern mask defect inspection system that uses the mask pattern inspection technology cultivated over many years and the inspection technology using EUV light.
Uses an inspection method that uses EUV light with a short wavelength.
Compared to conventional mask inspection machines using DUV lasers, the defect detection sensitivity is overwhelmingly high, and it is also possible to detect transferable phase defects unique to EUV masks.
https://www.lasertec.co.jp/topics/upload_files/20190912JP.pdf