
A flow of heated plasma (EUV light source) gathered in the center by laser irradiation from left to right
It was found that EUV light is emitted particularly efficiently from the bright areas in the figure.
The flow to the center reduces the speed at which the plasma diffuses to the periphery, effectively reducing contamination of the peripheral mirrors.
(Source: Hokkaido University press release PDF)
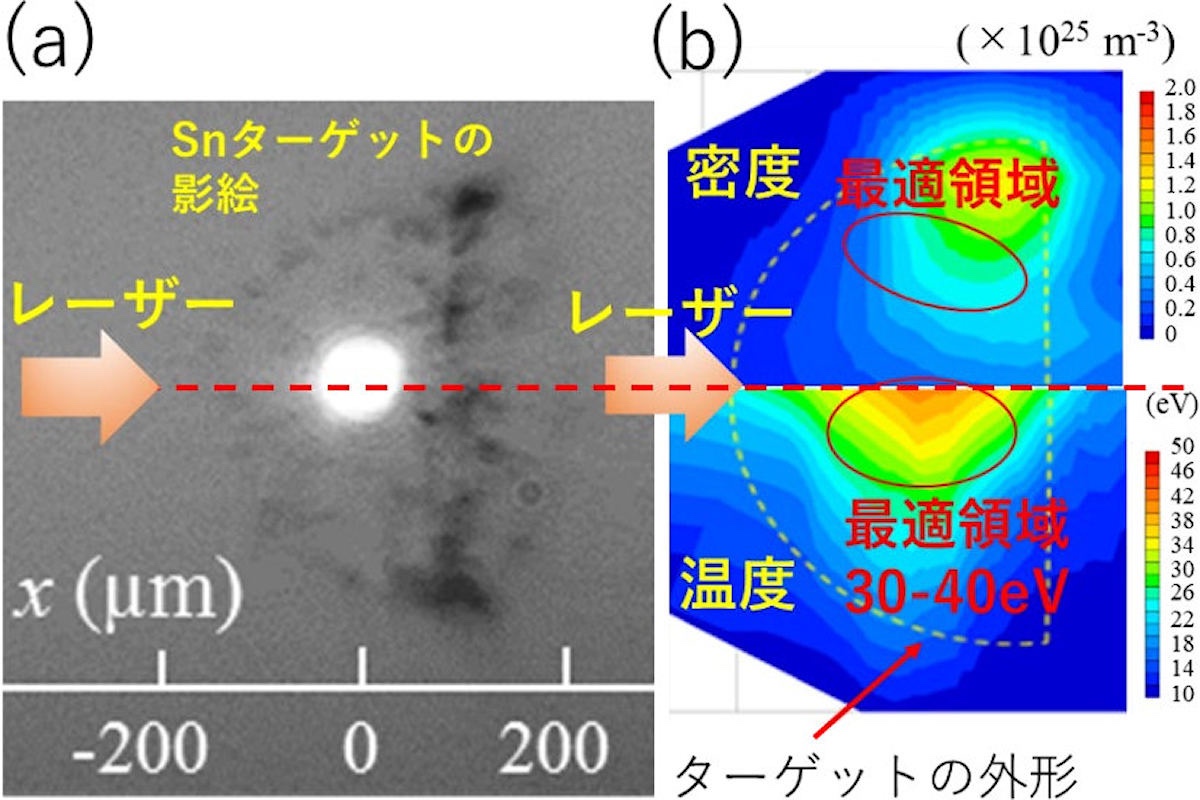
(a) Silhouette image of Sn target before plasma generation
(b) Profile of plasma electron density (top) and electron temperature (bottom)
The laser is emitted from left to right in the figure.
On the laser axis, the optimum temperature for EUV radiation is 30 to 40 eV (1 eV is about 10,000 degrees)
A hollow-like structure with a higher density in the periphery was confirmed.
(Source: Hokkaido University press release PDF)
EUV exposure technology: Elucidation of the structure of the light source plasma flow!
– Fabrication of “Differential Dispersion Grating Spectrometer” –
-Successful Observation of Light Source Plasma Flow-
Hokkaido University (Hokkaido University):
“EUV exposure technology” necessary for advanced semiconductor manufacturing
February 6th,
We clarified the structure of the complex flow of the light source plasma, which plays an important role in increasing the power output.
Associate Professor Kentaro Tomita, Graduate School of Hokkaido University,
Professor Emeritus Konobu Nishihara, Osaka University,
Purdue University Dr. Atsushi Sunahara
– By an international joint research team including Gigaphoton researchers –
Details were published in the British online comprehensive academic journal “Scientific Reports”.
EUV exposure technology:
Used by semiconductor manufacturers such as TSMC and Samsung Electronics.
Its wavelength is 13.5nm
It is not a combination of lenses that have been used for ArF and KrF exposure up to that point.
Light from the light source is delivered to the wafer using a combination of highly polished reflective mirrors.
Mirror reflectivity:
However, the reflectivity of the mirror is not high. The output is attenuated with each reflection.
High power light source:
In order to deliver a sufficient amount of light to the wafer, it is necessary to increase the output of the light source. However, it also requires more power.
Research and development continues today to achieve high throughput as well as low power consumption.
Principle of EUV light:
The principle of EUV light is still unclear.
The clarification includes:
It is necessary to measure “basic physical quantities such as the temperature and density of the light source plasma and the flow of the plasma.”
“For plasma control, they are important.”
Features of EUV light source plasma:
0.5mm in diameter,
Lifetime on the order of 20 ns,
and a density of about 0.2 kg/m3,
It has various features such as a movement speed of 10 km/s or more.
Its measurement has been difficult.
Until now, the development of EUV light sources has proceeded without knowing these basic physical quantities.
Therefore, the research team decided to try to measure them in this study.
Measure the plasma of an EUV light source:
Laser Thomson scattering (LTS) method is available as a means to measure EUV light source plasma.
Laser Thomson scattering (LTS) method:
A laser is injected from the outside and the scattered light generated by the interaction between the plasma and the laser is measured.
High spatial and temporal resolution can be obtained without contact.
Planning and fabrication of a differential dispersion grating spectrometer:
The problem is that the scattered light obtained is extremely weak, and it has been said that “LTS measurement of EUV light source plasma is technically impossible.”
Uses a reflective diffraction grating:
A “difference-dispersion grating spectrometer” consisting of six “reflection gratings” was fabricated.
Measurement using a spectrometer:
It was measured using a difference dispersion grating spectrometer.
Hollow-like structure of plasma:
At the central position of the plasma (on the axis of the plasma generation laser), it was found that “a hollow-like structure with a lower density than the peripheral part was formed”.
As a result of measurements under various conditions, the hollow-like structure of the plasma plays an important role in achieving high efficiency.
however,
When this hollow-like structure appears,
“Why high-density plasma suitable for EUV radiation is maintained for a relatively long time” was unknown.
Thomson scattered light spectrum:
Focus on Doppler shift
Therefore, the research team thought that “plasma temperature, density, and its flow are important.”
I decided to pay attention to “Doppler shift of Thomson scattered light spectrum”.
The plasma flow velocity is 1/10,000 of the speed of light.
Plasma flow information appears clearly in the Doppler shift of the received scattered light.
Analyze the Doppler shift:
As a result of advanced analysis of Doppler shift,
The direction of the plasma flow is reversed by 180 degrees and the magnitude of the flow varies in a minute area of about ±20 μm.
It was visualized as the existence of a fine velocity field structure and the absolute value of velocity (high-speed flow of 10 km/s).
Observing the plasma flow:
We also observed a characteristic plasma flow toward the central axis of the plasma.
The flow was not always present and depended on plasma generation conditions.
Control plasma flow:
It was found that the flow could be controlled under the same conditions.
Based on the “temporal and spatial changes in the temperature, density, and flow field” inside the plasma, we clarified that “the flow enhances the efficiency of EUV radiation.”
Plasma flow control is important:
According to this research, it is essential to optimize the temperature and density of the plasma in order to increase the output of EUV.
It was shown that plasma flow control is important to realize the optimum temperature and density.
especially,
“Inducing a flow toward the center effectively confines the glowing plasma for a long time.”
It was shown that plasma has a heat-retaining effect.
“The effect of suppressing the kinetic energy of the plasma by controlling the plasma flow” can also be expected.
Plasma velocity measurement technology:
-Non-contact visualization of flow field by plasma velocity measurement technology-
“From femtoseconds to nanoseconds,” observations in all laser processes can be realized.
In the future, we will not only develop EUV light sources but also apply it in a wide range of fields.
TECH+
https://news.mynavi.jp/techplus/article/20230207-2585644/
Un flux de plasma chauffé (source de lumière EUV) rassemblé au centre par irradiation laser de gauche à droite
Il a été constaté que la lumière EUV est émise de manière particulièrement efficace à partir des zones lumineuses de la figure.
Le flux vers le centre réduit la vitesse à laquelle le plasma se diffuse vers la périphérie, réduisant efficacement la contamination des miroirs périphériques.
(Source: communiqué de presse de l’Université d’Hokkaido PDF)
(a) Image de la silhouette de la cible Sn avant la génération de plasma
(b) Profil de la densité électronique du plasma (en haut) et de la température des électrons (en bas)
Le laser est émis de gauche à droite sur la figure.
Sur l’axe laser, la température optimale pour le rayonnement EUV est de 30 à 40 eV (1 eV correspond à environ 10 000 degrés)
Une structure en forme de creux avec une densité plus élevée à la périphérie a été confirmée.
(Source: communiqué de presse de l’Université d’Hokkaido PDF)
Technologie d’exposition EUV : Élucidation de la structure du flux plasma de la source lumineuse !
– Fabrication de “Spectromètre Différentiel à Réseau de Dispersion” –
-Observation réussie du flux de plasma de source lumineuse-
Université d’Hokkaido (Université d’Hokkaido):
“Technologie d’exposition EUV” nécessaire à la fabrication avancée de semi-conducteurs
6 février,
Nous avons clarifié la structure du flux complexe du plasma source de lumière, qui joue un rôle important dans l’augmentation de la puissance de sortie.
Professeur associé Kentaro Tomita, Graduate School of Hokkaido University,
Professeur émérite Konobu Nishihara, Université d’Osaka,
Université Purdue Dr Atsushi Sunahara
– Par une équipe de recherche conjointe internationale comprenant des chercheurs de Gigaphoton –
Les détails ont été publiés dans la revue universitaire britannique en ligne “Scientific Reports”.
Technologie d’exposition EUV :
Utilisé par les fabricants de semi-conducteurs tels que TSMC et Samsung Electronics.
Sa longueur d’onde est de 13,5 nm
Ce n’est pas une combinaison de lentilles qui ont été utilisées pour l’exposition ArF et KrF jusqu’à ce point.
La lumière provenant de la source lumineuse est transmise à la plaquette à l’aide d’une combinaison de miroirs réfléchissants hautement polis.
Réflectivité miroir :
Cependant, la réflectivité du miroir n’est pas élevée. La sortie est atténuée à chaque réflexion.
Source lumineuse haute puissance :
Afin de fournir une quantité suffisante de lumière à la plaquette, il est nécessaire d’augmenter le rendement de la source lumineuse. Cependant, il nécessite également plus de puissance.
La recherche et le développement se poursuivent aujourd’hui pour atteindre un débit élevé ainsi qu’une faible consommation d’énergie.
Principe de la lumière EUV :
Le principe de la lumière EUV n’est pas encore clair.
La clarification comprend :
Il est nécessaire de mesurer “des grandeurs physiques de base telles que la température et la densité du plasma de la source lumineuse et le flux du plasma”.
“Pour le contrôle du plasma, ils sont importants.”
Caractéristiques du plasma source de lumière EUV :
0,5 mm de diamètre,
Durée de vie de l’ordre de 20 ns,
et une masse volumique d’environ 0,2 kg/m3,
Il a diverses caractéristiques telles qu’une vitesse de déplacement de 10 km/s ou plus.
Sa mesure a été difficile.
Jusqu’à présent, le développement des sources lumineuses EUV s’est déroulé sans connaître ces grandeurs physiques de base.
Par conséquent, l’équipe de recherche a décidé d’essayer de les mesurer dans cette étude.
Mesurer le plasma d’une source lumineuse EUV :
La méthode de diffusion laser Thomson (LTS) est disponible comme moyen de mesurer le plasma de la source lumineuse EUV.
Méthode de diffusion laser Thomson (LTS) :
Un laser est injecté depuis l’extérieur et la lumière diffusée générée par l’interaction entre le plasma et le laser est mesurée.
Une résolution spatiale et temporelle élevée peut être obtenue sans contact.
Planification et fabrication d’un spectromètre différentiel à réseau de dispersion :
Le problème est que la lumière diffusée obtenue est extrêmement faible, et il a été dit que “la mesure LTS du plasma de la source de lumière EUV est techniquement impossible”.
Utilise un réseau de diffraction réfléchissant :
Un “spectromètre à réseau de dispersion différentielle” composé de six “réseaux de réflexion” a été fabriqué.
Mesure à l’aide d’un spectromètre :
Elle a été mesurée à l’aide d’un spectromètre à réseau de dispersion différentielle.
Structure creuse du plasma :
A la position centrale du plasma (sur l’axe du laser de génération de plasma), il a été constaté qu'”une structure en forme de creux avec une densité inférieure à la partie périphérique s’est formée”.
À la suite de mesures dans diverses conditions, la structure creuse du plasma joue un rôle important dans l’obtention d’un rendement élevé.
cependant,
Lorsque cette structure en forme de creux apparaît,
“Pourquoi le plasma à haute densité adapté au rayonnement EUV est maintenu pendant une période relativement longue” était inconnu.
Spectre de lumière diffusée Thomson :
Zoom sur le décalage Doppler
Par conséquent, l’équipe de recherche a pensé que “la température, la densité et le flux du plasma sont importants”.
J’ai décidé de prêter attention au “décalage Doppler du spectre de la lumière diffusée par Thomson”.
La vitesse d’écoulement du plasma est de 1/10 000 de la vitesse de la lumière.
Les informations sur le flux de plasma apparaissent clairement dans le décalage Doppler de la lumière diffusée reçue.
Analysez le décalage Doppler :
À la suite d’une analyse avancée du décalage Doppler,
La direction du flux de plasma est inversée de 180 degrés et l’amplitude du flux varie dans une zone minuscule d’environ ± 20 μm.
Il a été visualisé comme l’existence d’une structure de champ de vitesse fine et la valeur absolue de la vitesse (écoulement à grande vitesse de 10 km/s).
Observation du flux de plasma :
Nous avons également observé un flux de plasma caractéristique vers l’axe central du plasma.
Le flux n’était pas toujours présent et dépendait des conditions de génération du plasma.
Contrôler le flux de plasma :
Il a été constaté que le débit pouvait être contrôlé dans les mêmes conditions.
Sur la base des “changements temporels et spatiaux de la température, de la densité et du champ d’écoulement” à l’intérieur du plasma, nous avons précisé que “le flux améliore l’efficacité du rayonnement EUV”.
Le contrôle du flux plasma est important :
Selon ces recherches, il est essentiel d’optimiser la température et la densité du plasma afin d’augmenter le rendement des EUV.
Il a été démontré que le contrôle du flux de plasma est important pour obtenir la température et la densité optimales.
en particulier,
“L’induction d’un flux vers le centre confine efficacement le plasma incandescent pendant une longue période.”
Il a été démontré que le plasma a un effet de rétention de chaleur.
“L’effet de suppression de l’énergie cinétique du plasma en contrôlant le flux de plasma” peut également être attendu.
Technologie de mesure de la vitesse du plasma :
-Visualisation sans contact du champ d’écoulement par la technologie de mesure de la vitesse du plasma-
“De la femtoseconde à la nanoseconde”, des observations dans tous les processus laser peuvent être réalisées.
À l’avenir, nous développerons non seulement des sources lumineuses EUV, mais nous les appliquerons également dans un large éventail de domaines.
TECH+
Ein Strom aus erhitztem Plasma (EUV-Lichtquelle), der in der Mitte durch Laserbestrahlung von links nach rechts gesammelt wurde
Es zeigte sich, dass EUV-Licht besonders effizient aus den hellen Bereichen in der Abbildung emittiert wird.
Der Fluss zum Zentrum reduziert die Geschwindigkeit, mit der das Plasma zur Peripherie diffundiert, wodurch die Kontamination der peripheren Spiegel effektiv reduziert wird.
(Quelle: Pressemitteilung der Universität Hokkaido im PDF-Format)
(a) Silhouettenbild des Sn-Targets vor der Plasmaerzeugung
(b) Profil der Plasmaelektronendichte (oben) und Elektronentemperatur (unten)
Der Laser wird in der Figur von links nach rechts emittiert.
Auf der Laserachse liegt die optimale Temperatur für EUV-Strahlung bei 30 bis 40 eV (1 eV entspricht etwa 10.000 Grad)
Eine hohlartige Struktur mit einer höheren Dichte in der Peripherie wurde bestätigt.
(Quelle: Pressemitteilung der Universität Hokkaido im PDF-Format)
EUV-Belichtungstechnik: Aufklärung der Struktur des Lichtquellen-Plasmaflusses!
– Herstellung von “Differential Dispersion Grating Spectrometer” –
-Erfolgreiche Beobachtung des Plasmaflusses der Lichtquelle-
Hokkaido-Universität:
“EUV-Belichtungstechnologie”, die für die fortschrittliche Halbleiterfertigung erforderlich ist
6. Februar,
Wir haben die Struktur der komplexen Strömung des Plasmas der Lichtquelle aufgeklärt, die eine wichtige Rolle bei der Leistungssteigerung spielt.
Außerordentlicher Professor Kentaro Tomita, Graduiertenschule der Universität Hokkaido,
Emeritierter Professor Konobu Nishihara, Universität Osaka,
Purdue University Dr. Atsushi Sunahara
– Von einem internationalen gemeinsamen Forschungsteam mit Gigaphoton-Forschern –
Details wurden in der umfassenden britischen Online-Wissenschaftszeitschrift „Scientific Reports“ veröffentlicht.
EUV-Belichtungstechnologie:
Wird von Halbleiterherstellern wie TSMC und Samsung Electronics verwendet.
Seine Wellenlänge beträgt 13,5 nm
Es handelt sich nicht um eine Kombination von Objektiven, die bisher für die ArF- und KrF-Belichtung verwendet wurden.
Licht von der Lichtquelle wird unter Verwendung einer Kombination aus hochglanzpolierten reflektierenden Spiegeln an den Wafer geliefert.
Spiegelreflexion:
Das Reflexionsvermögen des Spiegels ist jedoch nicht hoch. Der Ausgang wird mit jeder Reflexion gedämpft.
Hochleistungslichtquelle:
Um dem Wafer eine ausreichende Lichtmenge zuzuführen, ist es erforderlich, die Ausgangsleistung der Lichtquelle zu erhöhen. Allerdings wird auch mehr Kraft benötigt.
Forschung und Entwicklung werden bis heute fortgesetzt, um einen hohen Durchsatz sowie einen geringen Stromverbrauch zu erreichen.
Prinzip des EUV-Lichts:
Das Prinzip von EUV-Licht ist noch unklar.
Die Aufklärung beinhaltet:
Es ist notwendig, “grundlegende physikalische Größen wie die Temperatur und Dichte des Plasmas der Lichtquelle und den Fluss des Plasmas” zu messen.
“Für die Plasmakontrolle sind sie wichtig.”
Merkmale des EUV-Lichtquellenplasmas:
0,5 mm Durchmesser,
Lebensdauer in der Größenordnung von 20 ns,
und einer Dichte von etwa 0,2 kg/m3,
Es hat verschiedene Eigenschaften wie eine Bewegungsgeschwindigkeit von 10 km/s oder mehr.
Ihre Messung war schwierig.
Bisher ist die Entwicklung von EUV-Lichtquellen ohne Kenntnis dieser physikalischen Grundgrößen vorgegangen.
Daher beschloss das Forschungsteam, zu versuchen, sie in dieser Studie zu messen.
Messen Sie das Plasma einer EUV-Lichtquelle:
Das Verfahren der Laser-Thomson-Streuung (LTS) ist als Mittel zur Messung des EUV-Lichtquellenplasmas verfügbar.
Laser-Thomson-Streuung (LTS)-Verfahren:
Ein Laser wird von außen eingekoppelt und das durch die Wechselwirkung zwischen Plasma und Laser erzeugte Streulicht gemessen.
Eine hohe räumliche und zeitliche Auflösung kann berührungslos erzielt werden.
Planung und Fertigung eines differentiellen Dispersionsgitter-Spektrometers:
Das Problem besteht darin, dass das erhaltene Streulicht extrem schwach ist, und es wurde gesagt, dass „eine LTS-Messung von EUV-Lichtquellenplasma technisch unmöglich ist“.
Verwendet ein reflektierendes Beugungsgitter:
Ein “Differenz-Dispersions-Gitter-Spektrometer”, bestehend aus sechs “Reflexionsgittern”, wurde hergestellt.
Messung mit einem Spektrometer:
Sie wurde unter Verwendung eines Differenz-Dispersionsgitter-Spektrometers gemessen.
Hohlartige Plasmastruktur:
An der zentralen Position des Plasmas (auf der Achse des Plasmaerzeugungslasers) wurde festgestellt, dass “eine hohlartige Struktur mit einer geringeren Dichte als der periphere Teil gebildet wurde”.
Als Ergebnis von Messungen unter verschiedenen Bedingungen spielt die hohle Struktur des Plasmas eine wichtige Rolle, um einen hohen Wirkungsgrad zu erreichen.
Jedoch,
Wenn diese hohle Struktur erscheint,
“Warum hochdichtes Plasma, das für EUV-Strahlung geeignet ist, relativ lange aufrechterhalten wird”, war unbekannt.
Thomson-Streulichtspektrum:
Konzentrieren Sie sich auf die Doppler-Verschiebung
Daher dachte das Forschungsteam, dass “Plasmatemperatur, -dichte und -fluss wichtig sind”.
Ich beschloss, auf “Dopplerverschiebung des Thomson-Streulichtspektrums” zu achten.
Die Plasmaströmungsgeschwindigkeit beträgt 1/10.000 der Lichtgeschwindigkeit.
Plasmaströmungsinformationen erscheinen deutlich in der Doppler-Verschiebung des empfangenen Streulichts.
Analysieren Sie die Dopplerverschiebung:
Als Ergebnis einer fortgeschrittenen Analyse der Doppler-Verschiebung,
Die Richtung des Plasmaflusses wird um 180 Grad umgekehrt und die Größe des Flusses variiert in einem winzigen Bereich von etwa ±20 μm.
Es wurde als Existenz einer feinen Geschwindigkeitsfeldstruktur und als Absolutwert der Geschwindigkeit (Hochgeschwindigkeitsströmung von 10 km/s) visualisiert.
Beobachtung des Plasmaflusses:
Wir beobachteten auch einen charakteristischen Plasmafluss in Richtung der Mittelachse des Plasmas.
Die Strömung war nicht immer vorhanden und hing von den Bedingungen der Plasmaerzeugung ab.
Kontrolle des Plasmaflusses:
Es wurde festgestellt, dass die Strömung unter den gleichen Bedingungen gesteuert werden konnte.
Basierend auf den “zeitlichen und räumlichen Änderungen der Temperatur, Dichte und des Strömungsfeldes” innerhalb des Plasmas stellten wir klar, dass “die Strömung die Effizienz der EUV-Strahlung erhöht”.
Plasmaflusskontrolle ist wichtig:
Gemäß dieser Forschung ist es wesentlich, die Temperatur und Dichte des Plasmas zu optimieren, um die Leistung von EUV zu erhöhen.
Es wurde gezeigt, dass die Steuerung des Plasmaflusses wichtig ist, um die optimale Temperatur und Dichte zu erreichen.
besonders,
“Durch das Induzieren einer Strömung zum Zentrum hin wird das leuchtende Plasma für lange Zeit effektiv begrenzt.”
Es konnte gezeigt werden, dass Plasma eine wärmespeichernde Wirkung hat.
“Der Effekt der Unterdrückung der kinetischen Energie des Plasmas durch Steuerung des Plasmaflusses” ist ebenfalls zu erwarten.
Plasmageschwindigkeitsmesstechnik:
-Berührungslose Visualisierung des Strömungsfeldes durch Plasmageschwindigkeitsmesstechnik-
„Von Femtosekunden bis Nanosekunden“ sind Beobachtungen in allen Laserverfahren realisierbar.
In Zukunft werden wir EUV-Lichtquellen nicht nur entwickeln, sondern in den unterschiedlichsten Bereichen anwenden.
TECH+
Observation of plasma inflows in laser-produced Sn plasma and their contribution to extreme-ultraviolet light output enhancement
Abstract
Plasma dynamics are governed by
electron density (ne),
electron temperature (Te),
and radiative energy transfer as well as by macroscopic flows.
However,
plasma flow-velocity fields (vflow) inside laser-produced plasmas (LPPs)
have rarely been measured, owing to their small sizes (< 1 mm) and short lifetimes (< 100 ns).
Herein, we report, for the first time,
two-dimensional (2D) vflow measurements of Sn-LPPs (“double-pulse” scheme with a CO2 laser) for extreme-ultraviolet (EUV) light sources for semiconductor lithography
using the collective Thomson scattering technique, which is typically used to measure ne, Te, and averaged ionic charge (Z) of plasmas.
Inside the EUV source,
we observed plasma inflow speed exceeding 104 m/s magnitudes toward a plasma central axis from its peripheral regions.
The time-resolved 2D profiles of ne, Te, Z, and vflow
indicate that the plasma inflows maintain the EUV source
at a temperature suitable (25 eV < Te < 40 eV) for EUV light emission at a high density (ne > 3 × 1024 m−3) and for a relatively long time (> 10 ns),
resulting increment of total EUV light emission.
These results
indicate that controlling the plasma flow can improve EUV light output and that there is potential to increase the EUV output further.
Scientific Reports