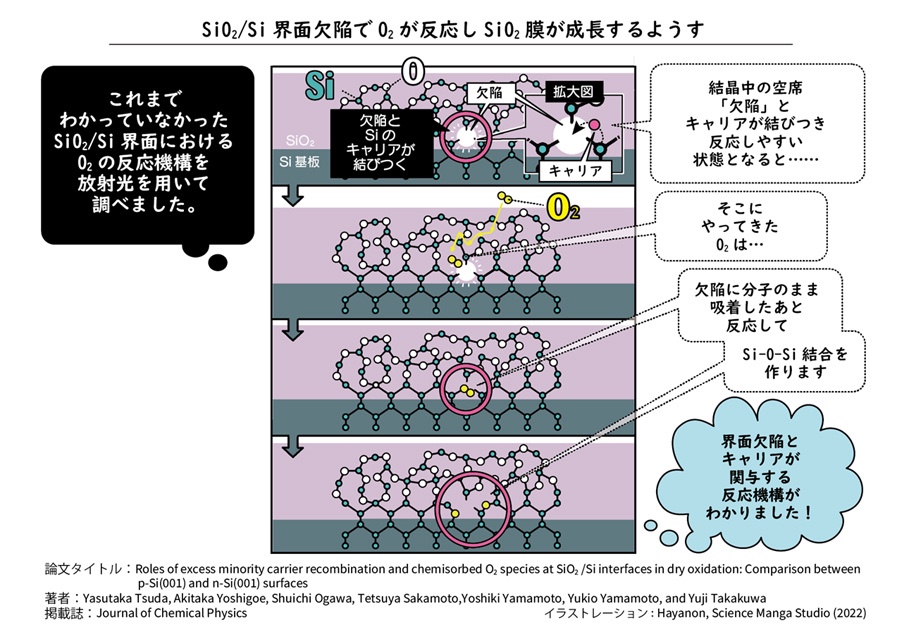
Silicon oxide film/SPring―8:界面欠陥を解明!
élucidation des défauts d’interface !
Aufklärung von Grenzflächendefekten !
Elucidation of interface defects !
闡明 SPring-8 的界面缺陷!
ーシリコン酸化膜の成長過程を追跡ー
日本原子力研究開発機構:
半導体産業を支える「シリコンの酸化膜が成長する機構」を明らかにした。
SPring―8:
SPring―8の高輝度放射光を使い、リアルタイムで反応を追跡した。
界面欠陥の原因を解明:
ー「酸化膜とシリコン基板の界面欠陥」をリアルタイム解析ー
酸素分子が反応する際、
「電気の伝導に寄与する電子や正孔など」が、関与することが分かった。
「半導体デバイスの省電力化、小型化、信頼性向上」につながる。
酸素分子の反応を解明:
「酸化膜とシリコン基板の界面にある欠陥で、酸素分子が反応すること」を解明した。
反応機構を詳細調査:
ー放射光を使ってリアルタイムで測定ー
「界面欠陥に、電子や正孔などが結び付いて、化学反応しやすい状態となること」が判明。
「反応しやすい欠陥が生じることで、酸素が分子のままで吸着する」のだ。
酸素原子に解離して、
「シリコン―酸素―シリコン結合を形成すること」を見いだした。
(ニュースイッチ) – Yahoo!ニュース
https://news.yahoo.co.jp/articles/2d83ab304b8d87ff964562c02b548c12167e21c4
高輝度放射光で解明:シリコン酸化膜の成長過程
~ナノデバイスの世界を支配する界面欠陥とキャリア捕獲~
【発表の要旨】
半導体デバイスの作製
半導体デバイスの作製では、
酸化反応を制御し欠陥の少ない、
良質なシリコン酸化膜を作製することが不可欠。
しかし、ナノレベルの薄膜領域におけるシリコン酸化反応機構の理解は不十分だ。
SPring-8で観察:
シリコン表面に極薄酸化膜が成長する過程をSPring-8放射光を用いてリアルタイム観察。
酸化膜とシリコン基板
界面欠陥との関連性その結果、酸化膜とシリコン基板の界面にある欠陥で酸素分子が反応する時、シリコン基板のキャリアが関与することを発見。
本成果は、シリコンを用いた半導体デバイスの省電力化、小型化、信頼性向上に貢献。
日本原子力研究開発機構:プレス発表
https://www.jaea.go.jp/02/press2022/p22121901/
Film d’oxyde de silicium : élucidation des défauts d’interface au SPring-8 !
– Suivi du processus de croissance des films d’oxyde de silicium –
Agence japonaise de l’énergie atomique :
Il a clarifié le “mécanisme de croissance du film d’oxyde de silicium” qui soutient l’industrie des semi-conducteurs.
Printemps-8 :
Les réactions ont été suivies en temps réel à l’aide d’un rayonnement synchrotron de haute intensité à SPring-8.
Clarification de la cause des défauts d’interface :
– Analyse en temps réel des défauts d’interface entre le film d’oxyde et le substrat de silicium –
Lorsque les molécules d’oxygène réagissent,
Il a été constaté que “des électrons, des trous, etc. qui contribuent à la conduction de l’électricité” sont impliqués.
Cela conduit à “l’économie d’énergie, la miniaturisation et l’amélioration de la fiabilité des dispositifs à semi-conducteurs”.
Clarifier les réactions moléculaires de l’oxygène :
“Film d’oxyde et substrat de silicium déficients à l’interface entre le film d’oxyde et le substrat de silicium : élucidation des défauts d’interface à SPring-8 !
– Suivi du processus de croissance des films d’oxyde de silicium –
Agence japonaise de l’énergie atomique :
Il a clarifié le “mécanisme de croissance du film d’oxyde de silicium” qui soutient l’industrie des semi-conducteurs.
Printemps-8 :
Les réactions ont été suivies en temps réel à l’aide d’un rayonnement synchrotron de haute intensité à SPring-8.
Clarification de la cause des défauts d’interface :
– Analyse en temps réel des défauts d’interface entre le film d’oxyde et le substrat de silicium –
Lorsque les molécules d’oxygène réagissent,
Il a été constaté que “des électrons, des trous, etc. qui contribuent à la conduction de l’électricité” sont impliqués.
Cela conduit à “l’économie d’énergie, la miniaturisation et l’amélioration de la fiabilité des dispositifs à semi-conducteurs”.
Clarifier les réactions moléculaires de l’oxygène :
Nous avons précisé que les molécules d’oxygène réagissent avec les défauts à l’interface entre le film d’oxyde et le substrat de silicium.
Étude détaillée du mécanisme de réaction :
– Mesure en temps réel par rayonnement synchrotron –
Il a été constaté que “les électrons, les trous, etc. sont liés aux défauts d’interface, créant un état qui facilite les réactions chimiques”.
“L’oxygène est adsorbé sous forme de molécules en raison de la formation de défauts facilement réactifs.”
se dissocier en atomes d’oxygène,
Ils ont découvert “la formation d’une liaison silicium-oxygène-silicium”.
(Nouveau commutateur) – Yahoo Actualités
Élucidation par rayonnement synchrotron à haute luminosité : processus de croissance d’un film d’oxyde de silicium
-Défauts interfaciaux et piégeage de porteurs qui dominent le monde des nanodispositifs-
[Résumé de la présentation]
Fabrication de dispositifs semi-conducteurs
Dans la fabrication de dispositifs semi-conducteurs,
La réaction d’oxydation est maîtrisée et les défauts sont peu nombreux,
Il est essentiel de produire un film d’oxyde de silicium de bonne qualité.
Cependant, la compréhension du mécanisme de réaction d’oxydation du silicium dans la région des couches minces au niveau nano est insuffisante.
Observé à SPring-8 :
Observation en temps réel du processus de croissance d’un film d’oxyde ultra-mince sur une surface de silicium en utilisant le rayonnement synchrotron SPring-8.
Film d’oxyde et substrat de silicium
Relation avec les défauts d’interface
En conséquence, ils ont découvert que les porteurs dans le substrat de silicium sont impliqués lorsque les molécules d’oxygène réagissent avec des défauts à l’interface entre le film d’oxyde et le substrat de silicium.
Cette réalisation contribue à l’économie d’énergie, à la miniaturisation et à l’amélioration de la fiabilité des dispositifs semi-conducteurs utilisant du silicium.
Agence japonaise de l’énergie atomique : Les molécules d’oxygène réagissent dans un communiqué de presse.
Étude détaillée du mécanisme de réaction :
– Mesure en temps réel par rayonnement synchrotron –
Il a été constaté que “les électrons, les trous, etc. sont liés aux défauts d’interface, créant un état qui facilite les réactions chimiques”.
“L’oxygène est adsorbé sous forme de molécules en raison de la formation de défauts facilement réactifs.”
se dissocier en atomes d’oxygène,
Ils ont découvert “la formation d’une liaison silicium-oxygène-silicium”.
(Nouveau commutateur) – Yahoo Actualités
Siliziumoxidfilm: Aufklärung von Grenzflächendefekten bei SPring-8!
– Verfolgung des Wachstumsprozesses von Siliziumoxidfilmen –
Japanische Atomenergiebehörde:
Er verdeutlichte den “Mechanismus des Siliziumoxidfilmwachstums”, der die Halbleiterindustrie unterstützt.
SPring-8:
Die Reaktionen wurden in Echtzeit mit hochintensiver Synchrotronstrahlung bei SPring-8 verfolgt.
Klärung der Ursache von Schnittstellendefekten:
– Echtzeitanalyse von Grenzflächendefekten zwischen Oxidschicht und Siliziumsubstrat –
Wenn Sauerstoffmoleküle reagieren,
Es wurde festgestellt, dass “Elektronen, Löcher usw., die zur Stromleitung beitragen”, beteiligt sind.
Es führt zu “Energieeinsparung, Miniaturisierung und Verbesserung der Zuverlässigkeit von Halbleitervorrichtungen”.
Aufklärung der sauerstoffmolekularen Reaktionen:
„Mangelhafte Oxidschicht und Siliziumsubstrat an der Grenzfläche zwischen Oxidschicht und Siliziumsubstrat: Aufklärung von Grenzflächendefekten bei SPring-8!
– Verfolgung des Wachstumsprozesses von Siliziumoxidfilmen –
Japanische Atomenergiebehörde:
Er verdeutlichte den “Mechanismus des Siliziumoxidfilmwachstums”, der die Halbleiterindustrie unterstützt.
SPring-8:
Die Reaktionen wurden in Echtzeit mit hochintensiver Synchrotronstrahlung bei SPring-8 verfolgt.
Klärung der Ursache von Schnittstellendefekten:
– Echtzeitanalyse von Grenzflächendefekten zwischen Oxidschicht und Siliziumsubstrat –
Wenn Sauerstoffmoleküle reagieren,
Es wurde festgestellt, dass “Elektronen, Löcher usw., die zur Stromleitung beitragen”, beteiligt sind.
Es führt zu “Energieeinsparung, Miniaturisierung und Verbesserung der Zuverlässigkeit von Halbleitervorrichtungen”.
Aufklärung der sauerstoffmolekularen Reaktionen:
Wir haben klargestellt, dass Sauerstoffmoleküle mit Defekten an der Grenzfläche zwischen dem Oxidfilm und dem Siliziumsubstrat reagieren.
Detaillierte Untersuchung des Reaktionsmechanismus:
– Echtzeitmessung mit Synchrotronstrahlung –
Es wurde festgestellt, dass “Elektronen, Löcher usw. an Grenzflächendefekte gebunden sind und einen Zustand schaffen, der chemische Reaktionen erleichtert”.
„Sauerstoff wird durch die Bildung leicht reaktiver Defekte in Form von Molekülen adsorbiert.“
dissoziieren in Sauerstoffatome,
Sie entdeckten “das Bilden einer Silizium-Sauerstoff-Silizium-Bindung”.
(Neuer Switch)-Yahoo!-Nachrichten
Aufklärung durch hochhelle Synchrotronstrahlung: Wachstumsprozess des Siliziumoxidfilms
-Grenzflächendefekte und Ladungsträgereinfang, die die Welt der Nanogeräte dominieren-
[Zusammenfassung der Präsentation]
Herstellung von Halbleiterbauelementen
Bei der Herstellung von Halbleiterbauelementen,
Die Oxidationsreaktion wird kontrolliert und es gibt nur wenige Defekte.
Es ist wesentlich, einen Siliziumoxidfilm guter Qualität herzustellen.
Jedoch ist das Verständnis des Reaktionsmechanismus der Siliziumoxidation in der Dünnschichtregion auf Nanoebene unzureichend.
Beobachtet bei SPring-8:
Echtzeitbeobachtung des Wachstumsprozesses eines ultradünnen Oxidfilms auf einer Siliziumoberfläche mit SPring-8-Synchrotronstrahlung.
Oxidfilm und Siliziumsubstrat
Zusammenhang mit Schnittstellendefekten
Als Ergebnis entdeckten sie, dass Ladungsträger im Siliziumsubstrat beteiligt sind, wenn Sauerstoffmoleküle mit Defekten an der Grenzfläche zwischen dem Oxidfilm und dem Siliziumsubstrat reagieren.
Diese Errungenschaft trägt zur Energieeinsparung, Miniaturisierung und verbesserten Zuverlässigkeit von Halbleitervorrichtungen unter Verwendung von Silizium bei.
Japan Atomic Energy Agency: Sauerstoffmoleküle reagieren in einer Pressemitteilung.
Detaillierte Untersuchung des Reaktionsmechanismus:
– Echtzeitmessung mit Synchrotronstrahlung –
Es wurde festgestellt, dass “Elektronen, Löcher usw. an Grenzflächendefekte gebunden sind und einen Zustand schaffen, der chemische Reaktionen erleichtert”.
„Sauerstoff wird durch die Bildung leicht reaktiver Defekte in Form von Molekülen adsorbiert.“
dissoziieren in Sauerstoffatome,
Sie entdeckten „das Bilden einer Silizium-Sauerstoff-Silizium-Bindung“.
(Neuer Switch)-Yahoo!-Nachrichten
Roles of excess minority carrier recombination and chemisorbed O2 species at SiO2/Si interfaces in Si dry oxidation:
Comparison between p-Si(001) and n-Si(001) surfaces:
The Journal of Chemical Physics: Vol 157, No 23
ABSTRACT
This study provides experimental evidence for the following:
(1) Excess minority carrier recombination at SiO2/Si interfaces is associated with O2 dissociative adsorption;
(2) the x-ray induced enhancement of SiO2 growth is not caused by the band flattening resulting from the surface photovoltaic effect
but by the electron–hole pair creation resulting from core level photoexcitation for the spillover of bulk Si electronic states toward the SiO2 layer;
and (3) a metastable chemisorbed O2 species plays a decisive role in combining two types of the single- and double-step oxidation reaction loops.
Based on experimental results,
the unified Si oxidation reaction model mediated by point defect generation
[S. Ogawa et al., Jpn. J. Appl. Phys., Part 1 59, SM0801 (2020)]
is extended from the viewpoints of
(a) the excess minority carrier recombination at the oxidation-induced vacancy site
(b) the trapping-mediated adsorption through the chemisorbed O2 species at the SiO2/Si interface.