
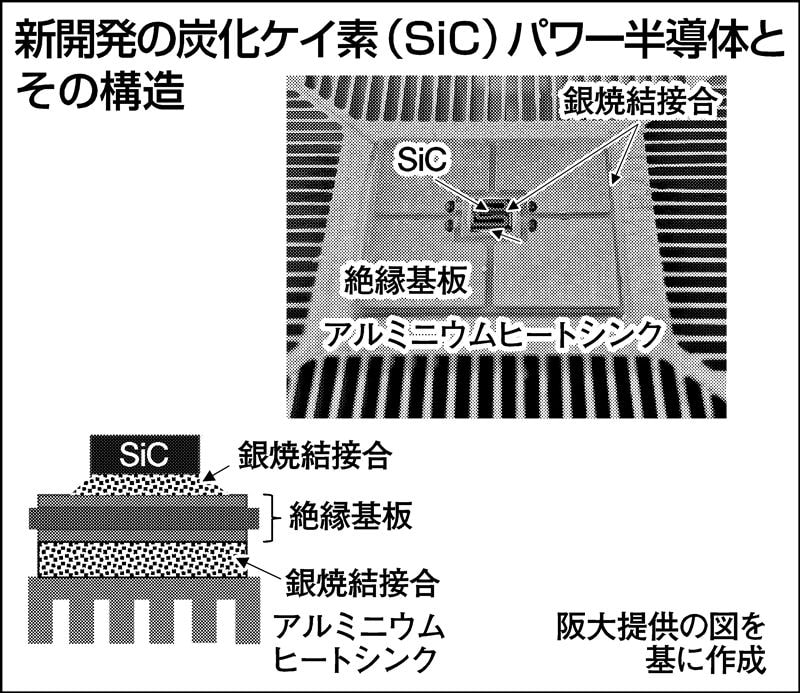
大阪大学:超低热阻碳化硅功率模块:银烧结接合技术
大阪大学 F3D 实施协作研究所
大和科学
我们使用我们专有的银烧结和接合技术开发了一种超低热阻 SiC 功率模块。
接头温度
从 270 摄氏度的常规焊点
它下降到180摄氏度。
有望应用于汽车和物联网设备等要求高耐热性和高可靠性的领域。
银烧结接合技术:
碳化硅和绝缘板,
铝制散热片,
通过低温低压银烧结直接粘合。
常规问题:
不再需要铝表面上的薄膜,例如传统上用于焊接接合所需的镍。
这个解决方案:
热阻降低一半左右,不妨碍散热,降低制造成本。
即使是无法加压粘合的散热器等复杂形状,也可以进行大面积粘合。
输出密度高,易于紧凑轻便。
碳化硅半导体的特性:
SiC半导体甚至可以在250°C或更高的高温下工作。
能量损失也小
汽车、铁路等
对工业机器人有需求。
传统上,散热是一个问题:
到现在为止,“使用焊料或油脂进行接合”一直是“热阻问题”。
这一次,散热得到了改善:
如果散热得到改善,将导致二氧化碳排放量的减少,为联合国的可持续发展目标做出贡献。
预计将用于后五代通信(6G)通信和航空航天工业。
新开关