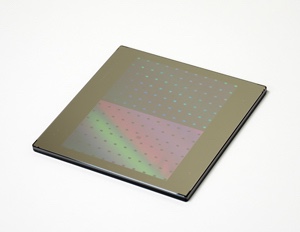
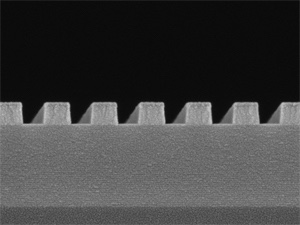
DNP:开发了5nm兼容的光掩模工艺:用于EUV光刻
2020年7月10日
大日本印刷(DNP):
通过使用使用多个电子束的掩模绘图系统,它与EUV(极端紫外线)光刻技术兼容,这是当前半导体制造中最先进的工艺。
我们已经开发了相当于5纳米(nm:10-9m)工艺的光掩模制造工艺。
[5nm最新半导体光掩模制造技术的特征]
光刻:缺点
在当今的半导体制造中,光刻技术用于在硅晶片上形成10 nm以上的电路图案。
但是,光刻技术由于使用准分子激光器例如波长为193nm的ArF(氟化氩)而受到分辨率的限制。
EUV光刻:优点
为了解决这个问题,EUV光刻使得通过使用波长为13.5nm的EUV作为光源来形成几nm的电路图案成为可能。
这种EUV光刻技术已开始在某些半导体制造商中投入实际使用,例如在5至7 nm工艺中的微处理器和尖端存储设备中。
未来的计划:
DNP
除了国内外的半导体制造商,
半导体开发协会,
制造设备制造商
给材料制造商等
提供用于EUV光刻的光掩模。
我们的目标是在2023年实现60亿日元的年销售额。
IMEC(大学微电子中心)
包括位于比利时的国际半导体研究所IMEC(大学微电子中心)
通过与合作伙伴的联合开发,我们将继续为3nm及以后的工艺开发更精细的工艺。
新闻| DNP日本立印刷
https://www.dnp.co.jp/news/detail/10158409_1587.html