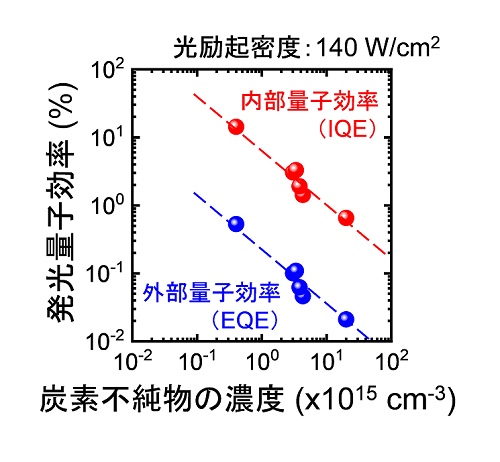
东北大学:GaN,检测痕量碳杂质:全向光致发光(ODPL)方法
东北大学:苏制株式会社
[公告要点]
建立氮化镓晶体中碳杂质的无损非接触检测方法
即使杂质浓度很小(小于1亿分之一),也可以进行检测
有助于高压晶体管和发光二极管
[总览]
东北大学先进材料多学科研究所与Psyox Corporation合作,通过全向光致发光(ODPL)方法* 1成功检测出氮化镓晶体中的痕量碳杂质。
半导体器件材料:GaN
取决于应用,使用各种材料来制造半导体器件。
氮化镓(GaN)作为适用于高性能电子和光学设备的材料之一,引起了人们的关注。
半导体器件性能:劣化因素
决定基于GaN的高压晶体管和大功率LED性能的因素之一是碳杂质。
由于即使痕量的碳也会降低器件性能,因此必须以高灵敏度对其进行检测。
然而,半导体中的杂质测量技术通常具有局限性,例如破坏性检查或需要在样品上形成电极。
全向光致发光法:杂质检测
Kojima等人的副教授应用半导体晶体的高精度发光效率* 3测量技术(全向光致发光法)。
建立了“对GaN中碳杂质的高灵敏度,非破坏性和非接触性检测方法”。
我们已经证明,即使使用超高纯度GaN晶体(浓度小于1200万),也可以定量和无损地测量碳浓度。
研究结果于12月4日在线发表在《应用物理快报》杂志上,该杂志是《日本物理科学学会》与日本物理学会之间的合作内部组织《物理科学杂志》(PCPAP)的科学期刊。
新闻发布・东北大学-
https://www.tohoku.ac.jp/japanese/2019/12/press20191205-02-ODPL.html